本篇目录:
- 1、io上的wirebond的电阻电容电感大概是多少
- 2、芯片wirebond金和铜线区别
- 3、clipbond和wirebond工艺主要差异
- 4、wirebond板子总是拉不到位,是怎么回事?
- 5、wirebond打线不需要加热
io上的wirebond的电阻电容电感大概是多少
电阻不用管频率;电容如果是电解电容频率应该调到120HZ,如果是小的贴片陶瓷电容应该调到1 KHZ.原因当然是电容的大小对应的频率特性不一样啊。电感一般使用1KHZ测试。
电感符号为L,电感单位:亨(H)、毫亨(mH)、微亨(μH)。电压符号U,际单位制为伏特(V,简称伏),常用的单位还有毫伏(mV)、微伏(μV)、千伏(kV)等。电流符号为I,单位是安培(A),简称安。
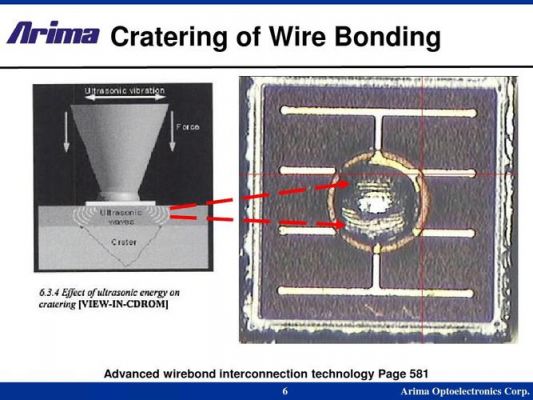
电容电感基本公式:电感:u=Ldi/dt;电容:i=cdv/dt。容抗用XC表示,电容用C(F)表示,频率用f(Hz)表示,那么Xc=1/2πfc容抗的单位是欧。知道了交流电的频率f和电容C,就可以用上式把容抗计算出来。
电感与电容串联后,总的阻抗Rz(注意不能称为电阻)等于感抗Rl和容抗Rc之差的绝对值,也就是Rz=IRc-RLI。
芯片wirebond金和铜线区别
1、wirebond封装铜线比相同线径的金线能承载更大的电流寄生电阻更大。根据查询相关公开信息,wirebond铜线比相同线径的金线能承载更大的电流。具体的铜线承载电流由铜线的性质决定,如纯度。杂质和合金物会降低铜线的电导率。

2、键合方式不一样。Clip bond为全铜片键合方式,Source pad是Clip方式,这个键合方法成本比较高,它的工艺较复杂,能获得更好的Rdson以及更好的热效应。
3、Wire Bond是焊线的意思,焊线也叫压焊,是用焊线机(也称压焊台),将金属丝线(如硅铝、金)固定在基座和芯片上,比如集成电路芯片焊线。
4、bond pad 就是焊盘。die bond工艺 在wire bond工艺前面,具体的原理和工艺就比较复杂了,现在die bond 有共金热压焊和银胶焊,还有薄膜焊,wire bond有金线,铜线,铝线焊,叫超声热压焊。

5、但氢氧化钠不会腐蚀铜线,最终可以把bond pad和铜线分离出来,可以检查bond pad和IMC,与金线IMC检查的方法一样。
6、COB: 是指Chip On Board。这种方式是将最原始的芯片(Bare Die,裸片),通过打线(Wire Bond)的方式把芯片上的信号和线路板连接在一起。这种方式需要有专门的DA,WB等一些列机台配合。
clipbond和wirebond工艺主要差异
1、而前面所说的“掺杂、注入、光刻、腐蚀”多用于单极型工艺,双级型也类似但具体还是有些不同的。die bond,wire bond则是封装工艺。如果我去回答面试的那几个问题时,我基本上就从“特征尺寸”和工艺流程上说一下。
2、后者包括传统封装工艺(Wirebond和FlipChip)和SMT设备。无源器件是SIP的一个重要组成部分,其中一些可以与载体集成为一体(Embedded,MCM-D等),另一些(精度高、Q值高、数值高的电感、电容等)通过SMT组装在载体上。
3、半导体后道工艺中“molding”是:注塑成型,就是把一片片已经焊上芯片(DIie Bond),焊上线(Wire Bond)的框架(Leadframe)塑封起来。
4、bond pad 就是焊盘。die bond工艺 在wire bond工艺前面,具体的原理和工艺就比较复杂了,现在die bond 有共金热压焊和银胶焊,还有薄膜焊,wire bond有金线,铜线,铝线焊,叫超声热压焊。
5、抗氧化性和使用寿命不同。抗氧化性不同:金线的抗氧化性好,表现优秀,稳定可靠,铜线更容易氧化。使用寿命不同:金线性质稳定,失效率低,使用寿命高,铜线易氧化,工艺不稳定,失效概率大,使用寿命难以保障。
wirebond板子总是拉不到位,是怎么回事?
1、键合方式不一样。Clip bond为全铜片键合方式,Source pad是Clip方式,这个键合方法成本比较高,它的工艺较复杂,能获得更好的Rdson以及更好的热效应。
2、没什么联系,die bond是焊片,将芯片焊接到框架上,wire bond是焊线,在已经焊好芯片的框架上,连接芯片上的焊盘和框架的管脚。bond pad 就是焊盘。
3、同时在练球把问题考虑的过细还会不自觉导致发力不集中的恶果。平时多做做空动作,体会发力的感觉,练球时注意力集中和发力集中。有一些基本而无误的常识就可以了。长此以往,必会成功。
4、io上的wirebond的电阻10,电容15,电感12。io上的wirebond是有系统设置的电阻,电感,电容的,注意保养,防止电阻,电感,电容被烧坏。
wirebond打线不需要加热
打线式贴片电阻,英文名称为WireBondableChipResistor,使用金属丝(金线、铝线等)完成贴片电阻内部互连接线的连接的电阻。
键合方式不一样。Clip bond为全铜片键合方式,Source pad是Clip方式,这个键合方法成本比较高,它的工艺较复杂,能获得更好的Rdson以及更好的热效应。
使用焊接接触器减小wirebond打线的方法:选择合适的焊接接触器:焊接接触器的尺寸、形状和材料都会影响打线的效果,选择合适的焊接接触器是减小wirebond打线的方法。
首先打开siwave,登录自己的账号。其次直接将.brd文件转换成.siw文件。最后点击添加wirebond,添加到指定位置即可。
COB: 是指Chip On Board。这种方式是将最原始的芯片(Bare Die,裸片),通过打线(Wire Bond)的方式把芯片上的信号和线路板连接在一起。这种方式需要有专门的DA,WB等一些列机台配合。
到此,以上就是小编对于的问题就介绍到这了,希望介绍的几点解答对大家有用,有任何问题和不懂的,欢迎各位老师在评论区讨论,给我留言。

 微信扫一扫打赏
微信扫一扫打赏